Infrarot-bga-Rework-Station
1. Hohe Erfolgsquote bei der Reparatur von Chips.
2. Einfache und einfache Bedienung
3. Infrarotheizung. Keine Beschädigung von PCB und Chip.
Beschreibung
BGA-Rework-Maschine für Tastaturkameras
1. Anwendung der BGA-Überarbeitungsmaschine für Tastaturkameras
Motherboard von Computer, Smartphone, Laptop, MacBook-Logikplatine, Digitalkamera, Klimaanlage, Fernseher und anderen elektronischen Geräten aus der medizinischen Industrie, Kommunikationsindustrie, Automobilindustrie usw.
Geeignet für verschiedene Arten von Chips: BGA, PGA, POP, BQFP, QFN, SOT223, PLCC, TQFP, TDFN, TSOP, PBGA, CPGA, LED-Chip.

2.Produktmerkmale der BGA-Überarbeitungsmaschine für Tastaturkameras

(1) Präzise Temperaturregelung.
(2) Hohe Erfolgsrate beim Reparieren von Chips.
(3) Zwei Infrarot-Heizbereiche erhöhen die Temperatur allmählich.
(4) Keine Beschädigung von Chip und PCB.
(5) CE-Zertifizierung garantiert.
(6) Tonhinweissystem: Es gibt eine Spracherinnerung 5s-10s vor Abschluss des Heizvorgangs, um den Bediener vorzubereiten.
(7) V-Nut-Leiterplatte funktioniert für eine schnelle, bequeme und genaue Positionierung, die alle Arten von Leiterplatten zur Positionierung erfüllen kann.
(8) V-Nut-Leiterplatte funktioniert für eine schnelle, bequeme und genaue Positionierung, die alle Arten von Leiterplatten zur Positionierung erfüllen kann.
3. Spezifikation der BGA-Überarbeitungsmaschine für Tastaturkameras
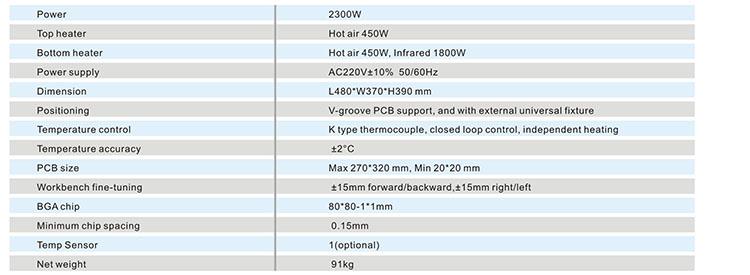
4.Details der BGA-Überarbeitungsmaschine für die Tastaturkamera
1. Zwei Infrarotheizzonen;
2.LED-Scheinwerfer;
3. Armaturenbrettbetrieb;
4. Begrenzungsbalken.

5. Zertifikat der BGA-Überarbeitungsmaschine für Tastaturkameras

6. Verpackung und Versand der BGA-Überarbeitungsmaschine für Tastaturkameras

7. Verwandtes Wissen
Der BGA-Verpackungsprozess
In den 1990er Jahren mit der Weiterentwicklung der Integrationstechnologie, der Verbesserung der Ausrüstung und der Verwendung der Deep-Submicron-Technologie. Ultra Deep Submicron Integrated Circuit Reliability ist eine nach der anderen aufgetaucht, Silizium-Single-Chip-Integration. Mit dem Grad der kontinuierlichen Verbesserung sind die Anforderungen an die Verpackung integrierter Schaltungen strenger geworden.
die Anzahl der I/O-Pins hat dramatisch zugenommen, und auch der Stromverbrauch hat zugenommen. Um den Anforderungen der Entwicklung gerecht zu werden, wurde dem Original ein neuer Typ von Ball Grid Array Package, abgekürzt als BGA (Ball Grid Array Package), hinzugefügt
Pakettypen.
(1) Merkmale des BGA-Gehäuses
Als BGA auftauchte, wurde es zur besten Wahl für High-Density-, High-Performance-, Multifunktional- und High-I/O-Pin-Packages für VLSI-Chips wie CPUs sowie North und South
Brücken. Seine Merkmale sind:
(1) Obwohl die Anzahl der E/A-Stifte zunimmt, ist der Stiftabstand viel größer als bei QFP, was die Montageausbeute verbessert;
(2)Obwohl sein Stromverbrauch zunimmt, kann BGA durch ein kontrolliertes Kollaps-Chip-Verfahren, abgekürzt als C4-Schweißen, gesteuert werden, das seine elektrothermische Leistung verbessern kann.
(3) Geeignet für die industrielle Produktion. Controlled Collapse Chip Connection C4-Technologie.












