Laser-Positions-Touchscreen-BGA-Rework-Maschine
Ursprünglich von Shenzhen Dinghua Technology entwickelt. DH-B2 ist eine perfekte Lösung für die BGA-Nachbearbeitung. Es handelt sich um eine einfache, schnelle und kostengünstige Technik für das BGA-Reballing in Mengen von wenigen bis zu mehreren Tausend Stück. Die große Auswahl an verfügbaren Mustern macht die BGA-Reworkstation DH-B2 zu einer attraktiven und flexiblen Lösung für BGA-Reballing-Anforderungen. Zu den typischen Anwendungen gehören die Reparatur auf Chipebene und das Reballing von BGA-Komponenten.
Beschreibung
1. Produkteigenschaften von LaserPOstionTAutschSBildschirmBGA (Englisch) ReworkMMaschine

1. Einzigartiges Design mit drei unabhängig voneinander arbeitenden Heizbereichen zur genaueren Temperaturregelung.
2. Der erste/zweite Temperaturbereich heizt unabhängig voneinander, wodurch 8 steigende Temperatursegmente und 8 eingerichtet werden können
Konstanttemperatursegmente zur Steuerung. Es können 10 Gruppen von Temperaturkurven gleichzeitig gespeichert werden.
3. Der dritte Bereich verwendet eine Ferninfrarotheizung, um die Temperatur unabhängig vorzuheizen und zu steuern, sodass die Leiterplatte
kann während des Entlötvorgangs vollständig vorgewärmt werden und darf keine Verformung aufweisen.
4. Wählen Sie einen importierten hochpräzisen K-Sensor und einen geschlossenen Regelkreis, um die Auf-/Ab-Temperatur präzise zu erfassen.
2.Spezifikation of LaserPOstionTAutschSBildschirmBGA ReworkMMaschine
| Leistung | 4800W |
| Oberheizung | Heißluft 800W |
| Unterhitze | Heißluft 1200 W, Infrarot 2700 W |
| Stromversorgung | AC220V+10% 50160Hz |
| Dimension | L800*B900*H750 mm |
| Positionierung | Leiterplattenhalterung mit V-Nut und externer Universalhalterung |
| Temperaturkontrolle | Thermoelement vom Typ K, Regelung mit geschlossenem Regelkreis, unabhängige Heizung |
| Temperaturgenauigkeit | ±2 Grad |
| PCB-Größe | Max. 450: 500 mm. Min. 20 x 20 mm |
| Feinabstimmung der Werkbank | ±15 mm vorwärts/rückwärts, ±15 mm rechts/links |
| BGAchip | 80 *80-1*1mm |
| Mindestspanabstand | {}.15mm |
| Temperatursensor | 4 (optional) |
| Nettogewicht | 36 kg |
3.Details of LaserPOstionTAutschSBildschirmBGA (Englisch) ReworkMMaschine
1. HD-Touchscreen-Schnittstelle;
2. Drei unabhängige Heizgeräte (Heißluft und Infrarot);
3. Vakuumstift;
4.LED-Scheinwerfer.
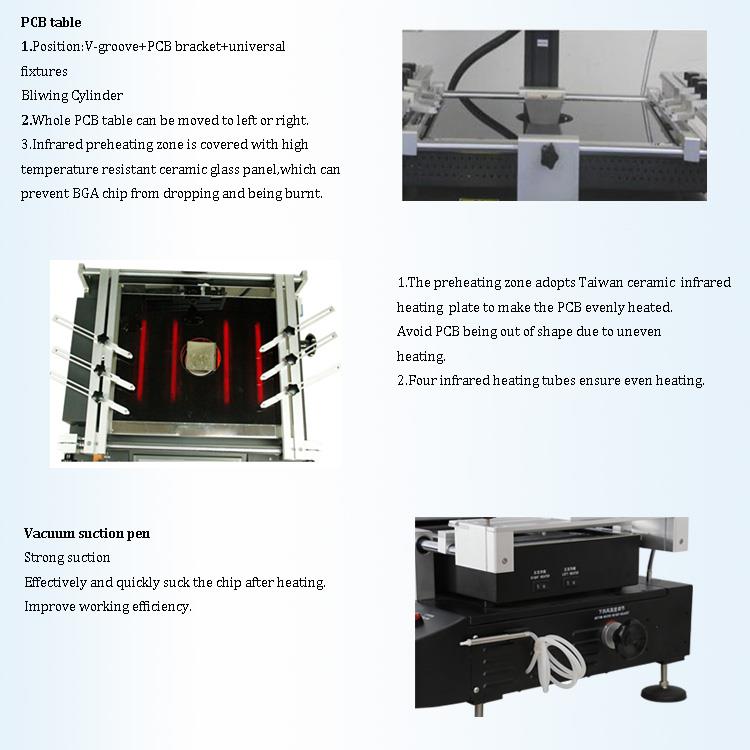


4.Warum sollten Sie sich für uns entscheiden? LaserPOstionTAutschSBildschirmBGA (Englisch) ReworkMMaschine?


5.Zertifikat

6.Verpackung und Versand


7.Video der BGA-Rework-Station DH-B2:
8. Verwandtes Wissen
Allgemeiner Prozess der Spantrocknung
- Vakuumverpackte Chips müssen nicht getrocknet werden.
- Wenn der vakuumverpackte Chip ausgepackt wird und die Feuchtigkeitsanzeigekarte in der Verpackung eine Luftfeuchtigkeit von mehr als 20 % RH anzeigt, muss ein Backen durchgeführt werden.
- Wenn die Chips nach dem Auspacken der Vakuumverpackung länger als 72 Stunden der Luft ausgesetzt sind, müssen sie getrocknet werden.
- Nicht vakuumverpackte ICs, die noch nicht verwendet werden oder von Entwicklern nicht verwendet wurden, müssen getrocknet werden, sofern sie nicht bereits trocken sind.
- Der Temperatur- und Feuchtigkeitsregler des Trockners sollte auf 10 % eingestellt sein und die Trocknungszeit sollte mindestens 48 Stunden betragen. Die tatsächliche Luftfeuchtigkeit sollte weniger als 20 % betragen, was als normal gilt.
Allgemeiner Prozess zum Backen von Chips
- Im versiegelten Zustand beträgt die Haltbarkeitsdauer der Komponente Dezember (Hinweis: Dies kann sich auf einen bestimmten Monat oder eine Haltbarkeitsdauer beziehen, dies ist jedoch im Originaltext unklar).
- Nach dem Öffnen der versiegelten Verpackung können die Bauteile bei Temperaturen unter 30 Grad und 60 % relativer Luftfeuchtigkeit im Reflow-Ofen verbleiben.
- Nach dem Öffnen der versiegelten Verpackung sollten die Komponenten, wenn sie nicht in Produktion sind, sofort in einer Trockenbox mit einer Luftfeuchtigkeit unter 20 % relativer Luftfeuchtigkeit gelagert werden.
- In den folgenden Fällen ist ein Backen erforderlich (gilt für Materialien mit Feuchtigkeitsgrad LEVER2 und höher):
- Überprüfen Sie beim Öffnen der Verpackung die Feuchtigkeitsanzeigekarte bei Raumtemperatur. Bei einer Luftfeuchtigkeit über 20 % ist Backen notwendig.
- Wenn die Komponenten nach dem Öffnen der Verpackung länger als die in der Tabelle angegebenen Grenzwerte weggelassen wurden und keine Komponenten zum Schweißen vorhanden sind.
- Wenn die Komponenten nach dem Öffnen der Verpackung nicht wie vorgeschrieben in einer Trockenbox mit weniger als 20 % relativer Luftfeuchtigkeit gelagert werden.
- Wenn die Komponenten ab dem Siegeldatum älter als ein Jahr sind.
5. Backzeit:
- In einem Niedertemperaturofen bei 40 °C ± 5 °C (mit einer Luftfeuchtigkeit unter 5 % relativer Luftfeuchtigkeit) 192 Stunden lang backen.
- Alternativ können Sie es auch im Ofen bei 125 °C ± 5 °C 24 Stunden lang backen.












